TempSave
ソルダペースト
- 融点
- 139-174℃
- 合金
- Sn-Bi系
製品一覧
| 品番 | TempSave B37 P610 D4 | TempSave B58 P610 D4 |
|---|---|---|
| バリエーション | (D4) | (D4) |
| 用途 | 低温はんだ付け用 | 低温はんだ付け用 |
| タイプ・特長 | 無銀耐衝撃性向上 | 無銀低ボイド |
| 合金 | Sn-0.5Cu-Ni-37Bi (+ other) | Sn-58Bi |
| 融点 | 139-174℃ | 139℃ |
| フラックス | P610 | P610 |
| フラックスカテゴリ | ROL0 | ROL0 |
| ハロゲン元素含有の有無 | 完全ハロゲンフリー | 完全ハロゲンフリー |
| 粒度 | D4 (Type 4):20-38µm | D4 (Type 4):20-38µm |
TempSave B37 P610 D4
- 低温はんだ付け用
- 無銀 / 耐衝撃性向上
衝撃に強い!Sn-Bi系はんだの弱点「耐衝撃性」を向上

衝撃に強い低融点鉛フリーソルダペースト。モバイル機器のような落下リスクの高い製品に最適です。低温はんだ付けができるため基板の反りも抑えます。
・耐衝撃
・省エネ(はんだ付け時の電気使用量を20-30%削減)
・ハロゲンフリー
ボールシェア試験後の破断面(SEM)比較
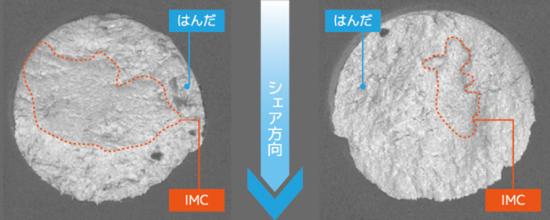
ボールシェア試験後の破断面(SEM)比較
写真左:Sn-58Bi
写真右:TempSave B37
はんだ領域が広い方が(TempSave B37)、応力吸収性に優れてることを示します。
薄型基板の実装に最適(基板の反りを防ぐ)

薄型基板の実装に最適(基板の反りを防ぐ)
200℃以下の温度域で実装できるため、モバイル機器やウエアラブル機器などに採用される薄型基板の反りを防ぎます。TempSave B58 P610 D4
- 低温はんだ付け用
- 無銀 / 低ボイド
低温実装により、はんだ付け時の電気使用量を最大30%削減!
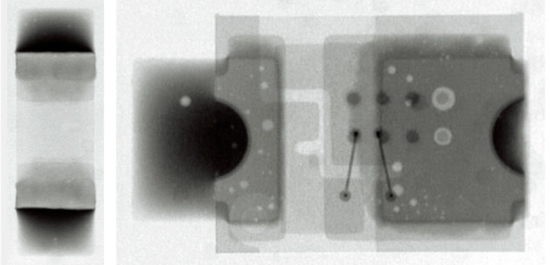
融点139℃。180℃以下の低温で実装できる低融点鉛フリーソルダペースト。低温実装により、はんだ付け設備の電気使用量を最大30%削減します。
・低ボイド
・省エネ(はんだ付け時の電気使用量を20-30%削減)
・ハロゲンフリー
LED式バックライト基板の実装において高評価

